
圖一:穿透式電子顯微鏡(影像來源:Shutterstock)
Å 尺度,也就是原子大小尺度。科學家對原子尺度世界的好奇,推動 Å 尺度檢測技術的發展,德國的 Prof. Ernst Ruska 於 1930 年代開領域先河,建置世界第一台穿透式電子顯微鏡(Transmission electron microscope,簡稱 TEM、CTEM),以加速電子的短波長打開具 Å 尺度解析力的可能性,人類自此有機會一窺原子尺度世界,此劃時代成就於 1986 年獲諾貝爾物理獎肯定,並催生不斷突破解析度紀錄的當代電子顯微學。
時至今日, 1Å 或是具更高解析度的穿透式電子顯微鏡已成商用化設備,孿生兄弟般的光學顯微鏡(Optical microscope)領域也已突破光學繞射(Diffraction)極限,往數十或甚至數 Å 解析度推展。具如此高解析度的當代電子顯微與光學顯微鏡,自然是分析 Å 世代半導體的必備工具,而其中一項關鍵挑戰在於量化檢測半導體中的結構、元素分佈特性等,檢視其是否依元件原始設計,以保障元件表現一如預期。
這些分析需求,絕對不是當代電子顯微鏡與光學顯微鏡可以單獨處理的,必須再進一步搭配能譜儀(Energy Dispersive Spectrometer,簡稱 EDS),甚至自行設計能譜儀,達到一邊看原子或微小區域,一邊量化分析其物理化學能譜,兩者搭配,才能真正協助 Å 世代半導體設計者釐清材料問題。
具 1Å 解析度的掃描穿透式電子顯微鏡搭配電子損失能譜儀,便是相當具代表性的 Å 尺度檢測工具,下圖二為一個應用範例。原子間距 ~2.7Å 的鈦(Ti)與鍶(Sr)於晶體中的元素分佈,透過電子損失能譜儀清析可辨,且圖中面積所需分析時間在掃描穿透式電子顯微鏡軟硬體整合開發的推進下,已由傳統所需的四分鐘縮短到十秒鐘,大幅提升分秒必爭的半導體廠線上元素分析應用可能性,其進一步元素量化分析也已證明可行。
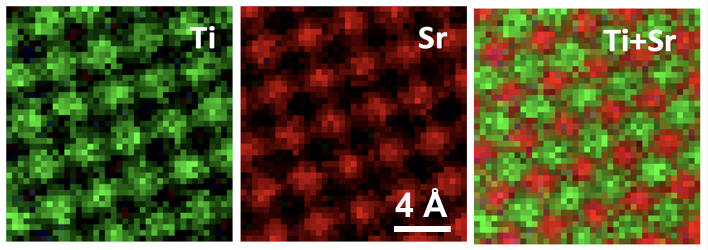
圖二、掃描穿透式電子顯微鏡結合電子損失能譜儀之元素分佈分析。(影像來源:國立臺灣大學凝態科學研究中心提供)
半導體元素分析的另一常用技術為具數 Å 解析度的掃描電子顯微鏡結合能量色散 X 光譜儀(energy dispersive X-ray spectrometer,簡稱 EDX)或波長色散 X 光譜儀(Wavelength-dispersive X-ray spectroscopy,簡稱 WDXS 或 WDS)。然而,這些能譜儀對原子序小於十的輕元素,受限於物理因素無法偵測,而這些元素又常見於半導體元件。因此,直接量測輕元素對加速電子的高熱吸收,成為一個可以解析其特性的方法。
下圖三便是測量此輕元素特性的原理,此新技術直接量測材料的熱吸收,所得到的材料影像亮度與對比為絕對值,不像傳統的掃描式電子顯微鏡其電訊號是相對值,影像對比易隨著操作者的不同調控喜好而變。這個絕對值特性使得利用熱吸收影像進行材料定量分析成為可能,又以其極高訊噪比,使得掃描電子顯微鏡成為數 Å 尺度下輕元素分析的新利器。

圖三、掃描式電子顯微鏡熱吸收訊號與樣品原子序的關係。(影像來源:國立臺灣大學凝態科學研究中心提供)
此外,半導體元件特性很大幅度受到其中缺陷態的影響,在二維半導體的效應尤其明顯,半導體缺陷分析因而日益重要。
傳統上要觀察到缺陷態位置的分佈,需要仰賴原子解析穿透式電子顯微鏡,然而,近年來各種超解析光學顯微技術的創新發展已可達到約 10Å 左右的解析度,大幅超越繞射極限,在生命科學的單分子觀察應用上有許多突破,並獲 2014 年諾貝爾化學獎肯定。
下圖四為以超解析光學觀念為基底,創新顯微鏡設計為載體,經由半導體放光飽和與閃爍非線性光學特性,具體實現 50 奈米空間解析度的創新光學超解析技術(詳見物理雙月刊專文),開創非破壞式半導體結構與缺陷態分析的可能性,並持續往更高的 10 奈米空間解析度邁進。
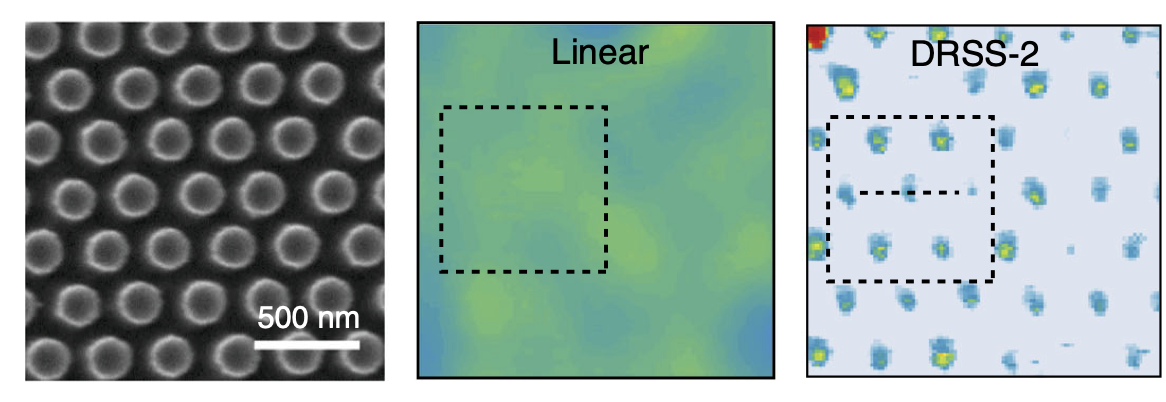
圖四、以光學方法在矽奈米結構上提供超解析觀察。左圖是直徑約170奈米的矽圓柱之電子顯微鏡影像;中圖是以一般線性光學顯微鏡的觀察結果,完全無法解析出個別奈米結構;右圖則是以非線性光學技術可以觀察到個別奈米結構,精確度達到50奈米等級。(影像來源:國立臺灣大學凝態科學研究中心提供)
另,Å 世代半導體的加速啟動與半導體產業極紫外光微影技術的商用化息息相關。
國人自主技術開發極紫外光相關技術將具關鍵效益,下圖四為自建之「真空紫外光雷射光譜顯微影像量測平台」,本技術採用工業級 266 奈米雷射光源,搭配雷射掃描共軛焦光譜顯微技術,依循艾司摩爾(ASML)極紫外光光刻機(Extreme ultraviolet lithography,簡稱 EUV 或 EUVL)的反射式光路設計理念,建構一套獨特的雷射光譜量測平台,除具有突破繞射極限的100奈米光學解析度潛力,探測深度更可達到優於 10 奈米的解析力。
將來若採用飛秒紫外光脈衝(Femtosecond UV pulses)雷射光源,則可藉由半導體材料的非線性光學吸收特性,進一步增強二至三倍空間解析力的效果。深具導入半導體廠研發實驗室,成為下世代關鍵光學檢測工具的未來性。
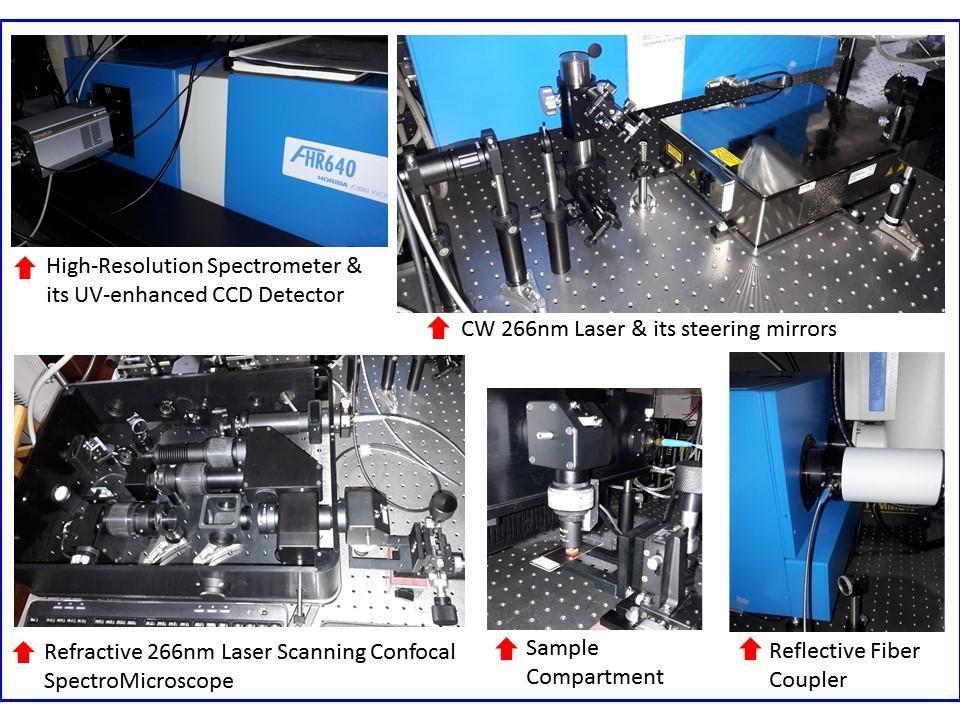
圖五、 開發線上檢測 Å 尺度半導體異質結構與元件所需之紫外光雷射掃描顯微光譜影像技術。(影像來源:國立臺灣大學凝態科學研究中心提供)
本著作係採用 創用 CC 姓名標示─非商業性─禁止改作 3.0 台灣 授權條款 授權.
本授權條款允許使用者重製、散布、傳輸著作,但不得為商業目的之使用,亦不得修改該著作。 使用時必須按照著作人指定的方式表彰其姓名。
閱讀授權標章或
授權條款法律文字。